18061770072 / 15358194655
18061770072 / 15358194655
發(fā)布時間:2024-03-08 發(fā)布時間:1457 發(fā)布時間:
隨著科技的發(fā)展,半導體器件和組件在工程、商業(yè)上得到了廣泛的應用。它在雷達、遙控遙測、航空航天等的大量應用對其可靠性提出了較高的要求,其中芯片的焊接(粘貼)方式也是對其可靠性非常重要的一個環(huán)節(jié)。
芯片到封裝體的焊接是指半導體芯片與載體(封裝殼體或基片)之間形成牢固的、傳導性或者絕緣性的連接方法。焊接層除了為器件提供機械連接和電連接之外,還需為器件提供良好的散熱通道。下面將針對芯片的焊接或粘貼方式進行一個詳細的說明。
在芯片到封裝體的焊接,有時芯片的背面無需將其電性能引出,因此會用非導電膠黏住芯片起到固定芯片位置的作用。這種非導電膠內(nèi)部主要以高分子樹脂體系為主,添加二氧化硅、氧化鋁、氮化硅等填料來提升材料的導熱性和絕緣性。非導電膠在實際使用的過程中可以通過點膠、絲網(wǎng)印刷等方式進行使用,然后通過加熱完成樹脂體系固化之后將芯片與基材焊接在一起。
芯片封裝中還有一種是要形成牢固的、傳導性的連接方法,即導電互聯(lián)。導電互聯(lián)的方式也很多種,如導電膠連接、金屬連接等。
導電膠是指在高分子樹脂粘合劑中添加了導電的金屬顆粒來實現(xiàn)其導通功能。在這中高分材料中,環(huán)氧樹脂是最經(jīng)常使用的。環(huán)氧樹脂是穩(wěn)定的線性聚合物,在加入固化劑后,環(huán)氧基打開形成羥基并交鏈,從而由線性聚合物交鏈成網(wǎng)狀結(jié)構而固化成熱固性塑料。其過程由液體或粘稠液→凝膠化→固體。固化的條件主要由固化劑種類的選擇來決定。而其中摻雜的金屬含量決定了其導電、導熱性能的好壞。
導電銀漿是當前更流行的芯片粘貼方法之一,它所需的固化溫度低,這可以避免熱應力,但有銀遷移的缺點。導電膠因其操作過程中載體不須加熱,設備簡單,易于實現(xiàn)工藝自動化操作且經(jīng)濟實惠而得到廣泛應用,尤其在集成電路和小功率器件中應用更為廣泛。但是使用導電膠的器件熱阻和電阻都很高。樹脂在高溫下容易分解,有可能發(fā)生填料的析出,在粘貼面上只留下一層樹脂使該處電阻增大。因此它不適于要求在高溫下工作或需低電阻的器件。另外,導電銀膠的機械強度遠不如共晶焊接強度大。
共晶焊又稱低熔點合金焊接。共晶合金的基本特性是:兩種不同的金屬可在遠低于各自的熔點溫度下按一定重量比例形成合金。在微電子器件中最常用的共晶焊是把硅芯片焊到鍍金的底座或引線框上去,即“金-硅共晶焊”。眾所周知,金的熔點1063℃,而硅的熔點更高,為1414℃。但是如果按照重量比為2.85 %的硅和97.15%的金組合,就能形成熔點為 363 ℃的共晶合金體。這就是金硅共晶焊的理論基礎。
金-硅共晶焊的焊接過程是指在—定的溫度(高于363 ℃ )和一定的壓力下,將硅芯片在鍍金的底座上輕輕揉動摩擦,擦去界面不穩(wěn)定的氧化層,使接觸表面之間熔化,由二個固相形成—個液相。冷卻后,當溫度低于金硅共熔點(363 ℃ )時,由液相形成的晶粒形式互相結(jié)合成機械混合物金-硅共镕晶體,從而使硅芯片牢固地焊接在底座上,并形成良好的低阻歐姆接觸。
共晶焊的金屬種類對連接影響很大,目前主要可做工晶焊的合金為AuGe、AuSn、AuSi、SnIn、SnAg等等,其可使用真空/可控氣氛共晶爐設備來實現(xiàn)。其具有熱導率熬、電阻小、傳熱快、可靠性強,粘結(jié)后剪切力大的優(yōu)點,適用于高頻、大功率器件中芯片與基板的焊接。對于散熱要求非常高的功率器件必須采用共晶焊接。
一般來說,焊接工藝中可以用焊料或者焊錫條進行焊接。焊料一般是通過預涂錫膏,然后用回流的方式進行焊接;而采用焊錫條則是進行芯片放置后,然后同樣采用回流的方式加工。一般焊錫膏其中一般包括兩部分助焊劑和焊料的部分。助焊劑一般多使用由松香、樹脂等活性劑、添加劑和有機溶劑組成的松香樹脂體系,然后焊料部分多為金屬合金。錫膏按照成分可以含鉛錫膏和無鉛錫膏,而按照熔點分類,則可以分為高溫錫膏、低溫錫高和不銹鋼錫膏。其中無鉛錫膏用于綠色電子產(chǎn)品的組裝;而高溫錫膏則應用于功率器件的封裝焊接。
焊料的加工發(fā)生主要為熱壓焊和回流焊。其中熱壓焊是利用脈沖加熱回流焊接,將兩個預先上好了助焊劑、鍍了錫的零件加熱到足以使得錫融化的溫度,冷卻固化后,這兩個零件就通過固化的焊錫形成一個電氣機械連接。而回流焊由于采用不同的熱源,回流焊機有:熱板回流焊接、熱風回流焊接、紅外回流焊接、紅外熱風回流焊機、汽相回流焊機、激光回流焊機等,不同的加熱方式,其原理是不一樣的。
燒結(jié)過程的驅(qū)動力主要來自體系的表面自由能和提醒的缺陷能,系統(tǒng)中顆粒尺寸越小,其比表面積越大,從而表面能越高、驅(qū)動力越大。外界對系統(tǒng)所施加的壓力、系統(tǒng)內(nèi)的化學勢差及量接觸顆粒間的應力也是擴散的驅(qū)動力。
以燒結(jié)銀為例,燒結(jié)得到的連接層為多孔性結(jié)構,空洞尺寸在微米及亞微米級別,連接層具有良好的導熱和導電性能,熱匹配性能良好。當連接層孔隙率為10%情況下,其導電及導熱能力可達到純銀的90%,遠高于普通的焊料。
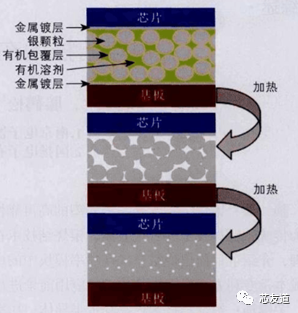
免責申明:本文文章轉(zhuǎn)自阿離 芯友道,文本、素材、圖片版權等內(nèi)容屬于原作者,本站轉(zhuǎn)載內(nèi)容僅供大家分享學習。如果侵害了原著作者得合法權益,請及時聯(lián)系我們,我們會安排刪除相關內(nèi)容。